Strukturierter Dünnfilm
Vermessen von SiO2 Stufenhöhen auf Si Substrat
Die DHM® Reflektometrie-Analyse-Software erlaubt das Messen der Höhe transparenter Stufen auf reflektierendem Substrat. Eine Publikation vergleicht die erfolgreichen Messungen gemacht mit dem DHM® und dem mechanischen Profiler.
Beschreibung
- Mikroskop: DHM® 2200
- Objektiv: 20x
- Software: Reflektometrie-Analyse-Software
- Sample
- Substrat: Si
- Stufen: SiO2
- Nominelle Stufenhöhen: 375nm, 525nm, 975nm, 1200nm und 1275nm
Resultate
- Substrat: Si
- Stufen: SiO2
- Nominelle Stufenhöhen: 375nm, 525nm, 975nm, 1200nm und 1275nm
Die Höhe jeder Stufe mit dem zugehörigen Brechungsindex errechnet die Reflektometrie-Analyse-Software.
Die Genauigkeit der DHM® Reflektometrie-Analyse wurde mit Vergleichsmessungen mit dem mechanischen Profilometer und dem AFM bewiesen. Es zeigt sich zudem, dass der Beginn der Stufen mit dem DHM® deutlicher hervor tritt, weil bei der berührenden Tastspitze wegen dem Spitzenradius die Ecken etwas abgerundet dargestellt werden.
Die DHM® Reflektometrie-Analyse Methode beinhaltet sub-Nanometer Höhenauflösung und erlaubt die schnelle und umfassende 3D Darstellung der Stufen.
Publikation
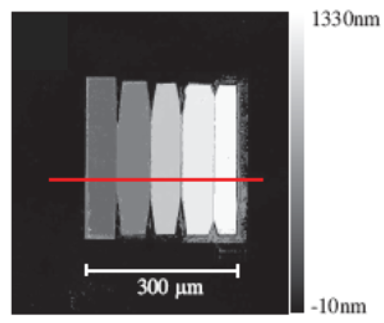

Si-SiO2-Au SIMS Krater Tiefenmessungen
Eine spezifische Anwendung sind sog. „Secondary Ion Mass Spectrometry“ (SIMS) Krater Messungen. Dabei geht es ums Vermessen der Tiefe von Minikratern, ausgehoben durch die SIMS Methode, durch Multiple Schichten von sowohl transparentem wie nicht-transparentem Material. SIMS ist eine Technik, bei der die Oberfläche mit einem fokussierten Ionenstrahl beschossen wird, dabei Sekundärionen herausschlägt, die sich analysieren lassen. Und zwar das Masse/Ladungs Verhältnis, anhand dessen sich die Material Zusammensetzung der Oberfläche bis in eine Tiefe von wenigen hundert Nanometern bestimmen lässt. Das Kennen der exakten Kratertiefe ist dabei essentiell für die präzise Charakterisierung der chemischen Zusammensetzung als eine Funktion der Tiefe.
Beschreibung
- Mikroskop: DHM® 2200
- Objektiv: 20x
- Software: Reflektometrie Analyse
- Sample: Secondary Ion Mass Spectrometry (SIMS) Ziel Sample: Krater durch Schichten von Au-SiO2-Si
- Au: Dicke (40 +/- 10) nm
- SiO2: Dicke (100 +/- 20) nm
Ergebnis
Die Genauigkeit der DHM® Tiefenmessungen wurde erfolgreich mit Standard Methoden wie dem mechanischen Profilometer verglichen. Die Resultate überzeugen, sie zeigen nicht nur akkurate Tiefenwerte, nein, das DHM® liefert gleich eine komplette 3D Charakterisierung des Kraters, schnell und berührungslos. AFM Charakterisierung: dazu ist der Krater zu gross, ist der Messbereich des AFM’s üblicherweise doch auf 100 µm x 100 µm beschränkt.
Publikation