4D Reflektometer
Charakterisieren transparenter Strukturen
Transparente Strukturen zu vermessen ist einzigartig mit dem DHM, sowohl die 3D Struktur wie die Dicke auf einem reflektierenden Substrat. Vermisst die Tiefe von SIMS Krater!
Vermisst Topographie, Dicke und Brechungsindex transparenter Strukturen.
- Messen der Oberflächenstruktur von 10 Nanometern bis zu mehreren Mikrometern.
- Messen des Brechungsindex
- Charakterisierung von abgeschiedenen wie auch geätzten Strukturen bestehend aus bis zu 3 Schichten
Flexibles Instrument
- Kontaktlose Methode, ideal um Flüssigkeiten und weiche Materialien zu vermessen
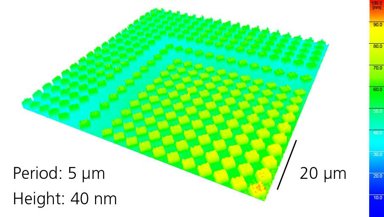
Die 3D Topograpie wie auch Schichtdicke und Brechungsindex von transparenten und strukturierten Oberflächen wird mit einer spezifischen Post-Analyse Software mit Berechnen der kompletten reflektierten Wellenfront nach den Gesetzen der Physik berechnet. Dies erlaubt es dem DHH auch dann noch die wahre Topographie zu berechnen, wenn alternative Systeme aufgrund von Mehrfachreflexionen des Lichts dazu nicht mehr in der Lage sind.
Strukturen in transparenten Materialien wie SiO2 und dünnen Metallschichten, weit verbreitet in der Halbleiter und MEMS Industrie, sind typische Beispiele solcher für das DHM® einfachen Messungen.
Auch beim Vermessen von Flüssigkeiten in mikrofluidischen Bauteilen oder auf funktionalisierten Oberflächen spielt das DHM® seine Stärken aus. Trotz Mehrfachreflexion zwischen Flüssigkeit und dem Substrat liefert es genaue dynamische Messungen.
Diese genannten Messungen mit dem DHM® umfassen das holographische Mikroskop von Lyncée Tec ausgestattet mit mehreren Objektiven, der Koala Aufnahme und Analyse Software sowie der spezifischen Reflektometrie Post-Analyse Software.
Vorteile
DHM® Technologie und ihre eigene Reflektometrie Post-Analyse Software bietet klare Vorteile.
Seien Sie innovativ dank Erweiterung der messbaren Teile
- Reflektometrie Analyse mit nur einem DHM® Instrument
- Messe die Topographie beschichteter Teile mit metrologischer Präzision
- Messe die Topographie auf Wafern mit Fotoresist
- Messe die Variation der dielektrischen Konstante (Hall effect)
- Messe die 3D Topographie von Flüssigkeiten und sonstigen weichen Material Oberflächen
Erhalte umgehend die Ergebnisse
- Kombiniere DHM® Reflektometrie Analyse Software mit Live Profilometrie, stroboskopischer Synchronization für schnelle Aufnahmen und industrieller Auswertung der Ergebnisse.
Kompetitive Stärken
- Berührendes Profilometer
- Ellipsometer
- Spectral Reflectance (SR)
- Konfokales Laser Scanning Mikroskop (CLSM)
- Weisslichtinterferometer (WLI)
DHM® vs. Berührendes Profilometer
| Features | DHM® | Berührendes Profilometer |
| Ohne Spuren | [ja] | [nein] |
| Nicht scannend | [ja] | [nein] |
| Weiche Materialien & Flüssigkeiten | [ja] | [nein] |
| Topographie Messungen | [ja] ohne scannen | [ja] XY scannen |
| Messungen des Brechungsindex | [ja] | [nein] |
| Messen dynamischer und bewegter Teile | [ja] | [nein] |
DHM® vs. Ellipsometer
| Features | DHM® | Ellipsometer |
| Nicht scannend | [ja] | [nein] |
| Dicken Messung | [10nm – 50μm] transparente Materialien |
[0.1nm – 0.01mm] nicht-metallisch
[0.1nm – 50nm] metallisch
|
| Messung des Brechungsindex | [ja] | [nein] |
| Topographie Messung | [ja] m/o scanning | [ja] XY scanning |
| Messen dynamischer und beweglicher Teile | [ja] | [nein] |
| Laterale Auflösung | ++ Objektiv Auflösung | – definiert über den Laser Spot Durchmesser |
| Preislich | ++ | – |
DHM® vs. Spectral Reflectance (SR)
Spectral Reflectance (SR) analysiert reflektiertes Licht und bestimmt so die Dicke und dielektrische Konstante des Films. Der Hauptunterschied zwischen Ellipsometrie und SR ist, das Erstere Licht mit einem schrägen Einfallswinkel benutzt, während Letztere Licht mit senkrechtem Einfall zur Probenoberfläche verwendet. Auswertung bei beiden über das zurück reflektierte Licht. SR ist eine einfache und kostengünstige Methode, die Messung ist aber nicht unmittelbar wegen der nötigen Spektralanalyse. Ebenso ist ein XY-scanning bei flächiger Messung nötig. SR übliche Anwendung sind Filme mit begrenzter Anzahl Schichten, mit Dicken >10 Mikrometer.
DHM® in Kombination mit der Reflektometrie Software misst die Dicke, von ein paar Nanometern bis zu mehreren Mikrometern, sowie die Topographie transparenter Strukturen mit interferometrischer Auflösung.
| Features | DHM® | Spectral Reflectance |
| Nicht-scannend | [ja] | [nein] |
| Dicken Messung | [10nm – 50μm] transparente Materialien |
[1nm – 1mm] nicht-metallisch
[0.5nm – 50nm] metallisch
|
| Messung des Brechungsindex | [ja] | [ja] |
| Topographie Messung | [ja] w/o scanning | [ja] XY scanning |
| Messung dynamischer und bewegter Teile | [ja] | [nein] |
| Laterale Auflösung | ++ Objektiv Auflösung | – definiert durch den Spot Durchmesser |
DHM® vs. Konfokales Laser-Scanning-Mikroskop (CLSM)
DHM® Reflektometrie baut nicht auf der Unterscheidung jeder Schichtgrenzfläche auf. Es baut auf das gesamte reflektierte Signal und liefert über die Gesetze der Optik präzise Angaben über die Schichtdicken von ein paar Nanometern bis mehreren Mikrometern. Zusätzlich, ohne jedes Scannen, vermisst das DHM® die 3D Topographie transparenter Strukturen mit interferometrischer Auflösung und bestimmt obendrein auch den Brechungsindex.
| Features | DHM® | CLSM |
| Nich-scannend | [ja] | [nein] |
| Dicken Bereich | 10nm – μm | >um |
| Topographie Messung | [ja] | [nein] |
| Messung des Brechungsindex | [ja] | [nein] |
| Messung dynamischer und bewegter Teile | [ja] | [nein] |
| Gesamtes reflektiertes Signal berücksichtigt | [ja] | [nein] |
DHM® vs. Weisslichtinterferometer (WLI)
| Features | DHM® | WLI |
| Verwendung monochromatischen Lichts | [ja] | [nein] |
| Nicht-scannend | [ja] | [nein] |
| Dicken Bereich | 10nm – μm | >um |
| Topographie Messung | [ja] | [nein] |
| Messung des Brechungsindex | [ja] | beschränkt |
| Messung dynamischer und bewegter Teile | [ja] | [nein] |
| Grosse Auswahl von Objektiven aus der Standard optischen Mikroskopie | [ja] | [nein] |
Anwendungen
In 2009, auf Anfrage eines DHM® Anwenders betr. Messen von SIMS Kratern, Lyncée Tec hat eine Lösung zur Interpretation optischer Messungen von Teilen mit transparenten Strukturen entwickelt. Seither wurde die Reflektometrie-Analyse-Software kontinuierlich verbessert, mit neuen Features und Auswerte Möglichkeiten. Aus vielen Messungen hat Lyncée Tec u.a. die folgenden vergleichenden Messungen geometrischer Topographie der folgenden Konfigurationen publiziert:
SiO2 Stufen auf Si Wafer
- Höhenmessung transparenter mehrschichtiger Stufen
- Berührungslose Messung der kompletten 3D Topographie ohne jedes Scannen
- Stufen Anfang/Ende jeweils präzise definiert
Krater in Schichten von Au-SiO2-Si
- Tiefenmessung von Kratern in transparenten Mehrfachschichten auf reflektivem Substrat
- Komplette 3D Topographie einer relative grossen Kraterfläche
- Tiefenbestimmung mit sub-Nanometer vertikaler Auflösung
Fluid Topographie auf Substrat
- Topographie Messung von Flüssigkeitstropfen (TetraEthylenGlycol, TEG) auf Si Substrat
- Nicht berührende und damit nicht-invasive Messmethode
- Einzigartige Methode für komplette 3D Charakterisierung von Flüssigkeits- oder Softmaterial-Tropfen